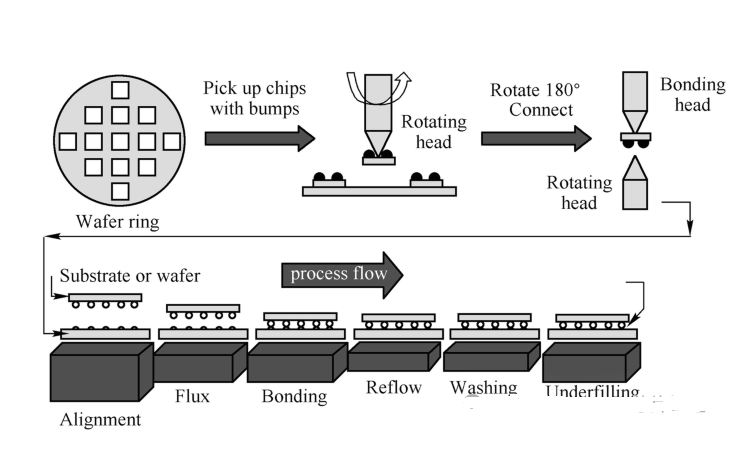
Хай ’ працягне вывучаць працэс размяшчэння чыпаў.
Як паказана на вокладцы.
1. Пікап-чыпсы з няроўнасцямі:
На гэтым этапе пласціна была нарэзана кубікамі на асобныя кавалачкі, прылепленыя да сіняй або УФ-плёнкі. Калі патрабуецца падняць фішку, штыфты выступаюць знізу, асцярожна націскаючы на заднюю частку фішкі, злёгку прыўздымаючы яе. Пры гэтым вакуумная насадка акуратна падхоплівае чып зверху, такім чынам адрываючы чып ад сіняй плёнкі або УФ-плёнкі.
2. Арыентацыя чыпа:
Пасля таго, як чып падхопліваецца вакуумнай насадкай, ён перадаецца ў галоўку Bonding Head, і падчас перадачы, арыентацыя чыпа змяняецца так, што бок з няроўнасцямі глядзіць уніз, гатовы да выраўноўвання з падкладкай.
3. Выраўноўванне чыпа:
Няроўнасці павернутага чыпа дакладна выраўнаваны з падушачкамі на ўпаковачнай падкладцы. Дакладнасць выраўноўвання мае вырашальнае значэнне для таго, каб кожная няроўнасць дакладна супадала з становішчам пляцоўкі на падкладцы. Флюс наносіцца на пляцоўкі на падкладцы, які служыць для ачысткі, памяншэння павярхоўнага нацяжэння на шарыках прыпоя і спрыяе цячэнню прыпоя.
4. Склейванне мікрасхем:
Пасля выраўноўвання чып асцярожна кладзецца на падкладку з дапамогай злучальнай галоўкі з наступным прымяненнем ціску, тэмпературы і ультрагукавой вібрацыі, што прымушае шарыкі прыпоя асядаць на падкладку, але гэтая першапачатковая сувязь не моцная.
5. Пераплаўленне:
Высокая тэмпература працэсу паяння аплаўленнем плавіцца і расцякае шарыкі прыпоя, ствараючы больш цесны фізічны кантакт паміж няроўнасцямі чыпа і пляцоўкамі падкладкі. Тэмпературны профіль для паяння аплавленнем складаецца з этапаў папярэдняга нагрэву, вымочвання, аплавлення і астуджэння. Па меры паніжэння тэмпературы расплаўленыя шарыкі прыпоя зноў застываюць, значна ўмацоўваючы сувязь паміж шарыкамі прыпоя і пляцоўкамі падкладкі.
6. Мыццё:
Пасля завяршэння паяння аплаўленнем на паверхнях чыпа і падкладкі будзе рэшткавы флюс. Такім чынам, для выдалення рэшткаў флюсу неабходна спецыяльнае чысціць сродак.
7. Недапаўненне:
Эпаксідная смала або аналагічны матэрыял упырскваецца ў зазор паміж чыпам і падкладкай. Эпаксідная смала ў першую чаргу дзейнічае як буфер для прадухілення расколін на няроўнасцях з-за празмернага напружання падчас наступнага выкарыстання.
8. Ліццё:
Пасля зацвярдзення герметычнага матэрыялу пры адпаведнай тэмпературы праводзіцца працэс фармавання з наступным тэставаннем надзейнасці і іншымі праверкамі, што завяршае ўвесь працэс інкапсуляцыі чыпа.
Вось і ўся інфармацыя пра пераваротны чып у тэхніцы SMT. Калі вы хочаце даведацца больш, проста прымайце заказ у нас.

 Беларус
Беларус English
English Español
Español Português
Português русский
русский français
français 日本語
日本語 Deutsch
Deutsch Tiếng Việt
Tiếng Việt Italiano
Italiano Nederlands
Nederlands ไทย
ไทย Polski
Polski 한국어
한국어 Svenska
Svenska magyar
magyar Malay
Malay বাংলা
বাংলা Dansk
Dansk Suomi
Suomi हिन्दी
हिन्दी Pilipino
Pilipino Türk
Türk Gaeilge
Gaeilge عربى
عربى Indonesia
Indonesia norsk
norsk اردو
اردو čeština
čeština Ελληνικά
Ελληνικά Українська
Українська Javanese
Javanese فارسی
فارسی தமிழ்
தமிழ் తెలుగు
తెలుగు नेपाली
नेपाली Burmese
Burmese български
български ລາວ
ລາວ Latine
Latine Қазақ
Қазақ Euskal
Euskal Azərbaycan
Azərbaycan slovenský
slovenský Македонски
Македонски Lietuvos
Lietuvos Eesti Keel
Eesti Keel Română
Română Slovenski
Slovenski मराठी
मराठी Српски
Српски 简体中文
简体中文 Esperanto
Esperanto Afrikaans
Afrikaans Català
Català עִברִית
עִברִית Cymraeg
Cymraeg Galego
Galego 繁体中文
繁体中文 Latvietis
Latvietis icelandic
icelandic יידיש
יידיש Hrvatski
Hrvatski Kreyòl ayisyen
Kreyòl ayisyen Shqiptar
Shqiptar Malti
Malti lugha ya Kiswahili
lugha ya Kiswahili አማርኛ
አማርኛ Bosanski
Bosanski Frysk
Frysk ជនជាតិខ្មែរ
ជនជាតិខ្មែរ ქართული
ქართული ગુજરાતી
ગુજરાતી Hausa
Hausa Кыргыз тили
Кыргыз тили ಕನ್ನಡ
ಕನ್ನಡ Corsa
Corsa Kurdî
Kurdî മലയാളം
മലയാളം Maori
Maori Монгол хэл
Монгол хэл Hmong
Hmong IsiXhosa
IsiXhosa Zulu
Zulu Punjabi
Punjabi پښتو
پښتو Chichewa
Chichewa Samoa
Samoa Sesotho
Sesotho සිංහල
සිංහල Gàidhlig
Gàidhlig Cebuano
Cebuano Somali
Somali Точик
Точик O'zbek
O'zbek Hawaiian
Hawaiian سنڌي
سنڌي Shinra
Shinra հայերեն
հայերեն Igbo
Igbo Sundanese
Sundanese Lëtzebuergesch
Lëtzebuergesch Malagasy
Malagasy Yoruba
Yoruba